一种划痕深度测量装置及方法与流程 |
您所在的位置:网站首页 › 测量划痕深度的设备 › 一种划痕深度测量装置及方法与流程 |
一种划痕深度测量装置及方法与流程
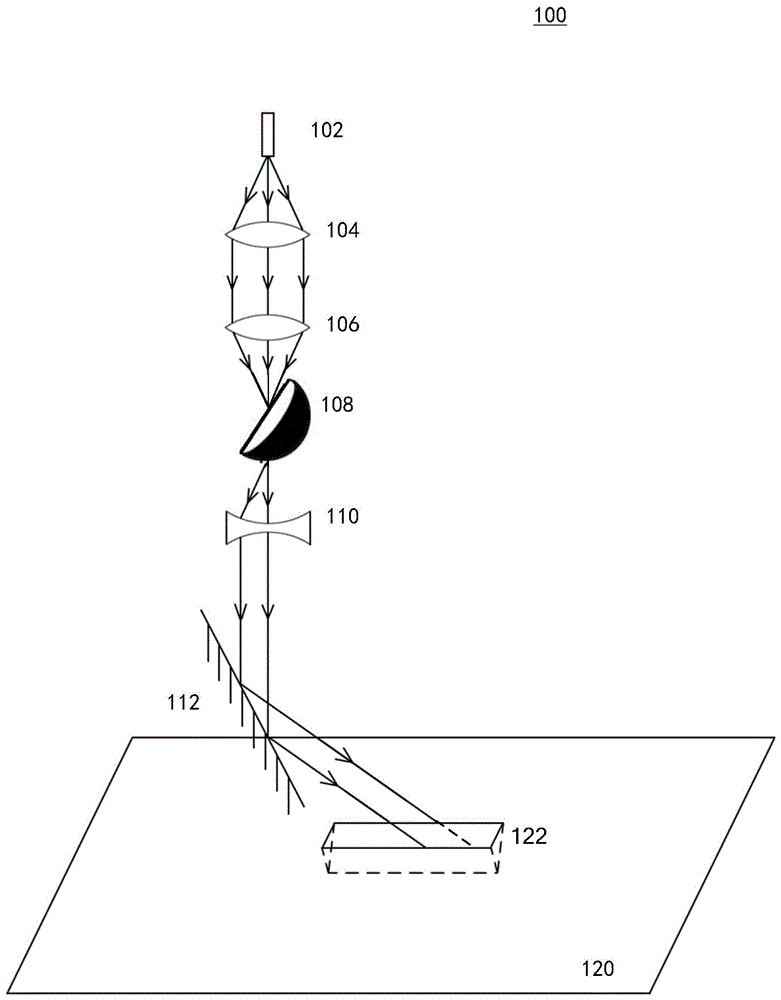 本公开一般涉及测量技术领域,尤其涉及用于物体表面划痕深度的检测。 背景技术: 在现代制造领域,尤其是民用飞机等领域,生产制造过程中由于保护不当等原因,易在机件表面造成划伤。通常划伤的宽度较小,现有测量装置难以准确测量机件表面的划伤深度,让划伤工程处置人员无法准确判断损伤的严重程度,从而影响划伤的正确处置。 例如,一类现有技术的划痕深度测量技术为机械接触式直接测量。采用此类技术的设备在测量过程中会导致测量表面出现二次损伤。另一类现有技术的划痕深度测量技术涉及以光学方式向待检测机件表面投射光束以形成划痕影像的方式来测量划痕深度。然而,现有测量设备及方法无法满足对大量曲面结构的高精度灵活测量要求。 综上,希望有操作方便简单、测量准确可靠、且能灵活应对各种曲面结构的划痕深度测量装置及方法。 技术实现要素: 本公开的一方面涉及一种划痕深度测量装置,包括光路子系统,所述光路子系统包括光源和挡片,用于产生部分被遮挡的平行光以照射被测表面;调节子系统,用于调节所述部分被遮挡的平行光照射被测表面的照射角度;以及成像子系统,包括用于采集所述被测表面的半明半暗的影像的相机和数据处理部分,其中若所采集到的半明半暗的影像上有底边在明暗分界线上并具有尖点的突起部分,则所述数据处理部分至少部分地基于所述照射角度和对所述影像中所述尖点与所述明暗分界线之间的距离的测量来确定所述被测表面上的划痕的深度。 根据一示例性实施例,所述照射角度包括所述平行光在所述挡片同侧与所述被测表面所成的角度。 根据一示例性实施例,所述光路子系统包括平面反射镜,其中所述调节子系统至少通过调节所述平面反射镜的角度来调节所述照射角度。 根据一示例性实施例,所述成像子系统包括相机,其中当所述调节子系统调节所述平面反射镜的角度时,所述相机的位置被相应地调节。 根据一示例性实施例,所述光路子系统还包括位于所述挡片之前的凸透镜和位于所述挡片之后的凹透镜,所述凸透镜用于会聚所述光源发出的光,并且所述凹透镜用于使被挡片遮挡后的光形成所述部分被遮挡的平行光。 根据一示例性实施例,所述挡片包括截面为锐角三角形的不透光半圆形挡片。 根据一示例性实施例,所述调节子系统进一步用于调节所述划痕深度测量装置的中轴线与所述划痕的方向角度以使得所述划痕的影像落在所述相机的视界中。 根据一示例性实施例,所述数据处理部分进一步用于补偿所述被测表面的曲率半径导致的划痕深度测量误差。 根据一示例性实施例,该划痕深度测量装置进一步包括沿所述划痕深度测量装置的中轴线方向与所述被测表面接触的至少两个支点,其中所述成像子系统进一步用于补偿所述被测表面的曲率半径导致的划痕深度测量误差包括所述数据处理部分基于所述曲率半径和所述至少两个支点在所述中轴线方向上的距离来修正所述照射角度。 根据一示例性实施例,当所述被测表面为凸面时,所述数据处理部分相应减小所述照射角度;或者当所述被测表面为凹面时,所述数据处理部分相应增大所述照射角度。 根据本公开的另一方面,一种划痕深度测量方法包括以部分被遮挡的平行光照射被测表面;通过相机采集所述被测表面的半明半暗的影像;以及若所采集到的半明半暗的影像上有底边在明暗分界线上并具有尖点的突起部分,则至少部分地基于所述照射角度和对所述影像中所述尖点与所述明暗分界线之间的距离的测量来确定所述被测表面上的划痕的深度。 根据一示例性实施例,所述照射角度包括所述平行光在所述挡片同侧与所述被测表面所成的角度。 根据一示例性实施例,该方法进一步包括调节所述部分被遮挡的平行光照射被测表面的照射角度。 根据一示例性实施例,该方法进一步包括当调节所述照射角度时,相应地调节所述相机的位置。 根据一示例性实施例,该方法进一步包括通过光源和挡片来形成所述部分被遮挡的平行光。 根据一示例性实施例,该方法进一步包括通过位于所述挡片之前的凸透镜会聚所述光源发出的光;以及通过位于所述挡片之后的凹透镜形成所述部分被遮挡的平行光。 根据一示例性实施例,该方法进一步包括调节与所述划痕的方向角度以使得所述划痕的影像落在所述相机的视界中。 根据一示例性实施例,该方法进一步包括补偿所述被测表面的曲率半径导致的划痕深度测量误差。 根据一示例性实施例,补偿所述被测表面的曲率半径导致的划痕深度测量误差包括当所述被测表面为凸面时,相应减小所述照射角度;或者当所述被测表面为凹面时,相应增大所述照射角度。 本公开还涉及其他示例性方面。 附图说明 图1示出了根据本公开一方面的划痕深度测量方案的光路图。 图2示出了根据本公开的一方面的示意性光切面的示意图。 图3示出了根据本公开一方面的示意性划痕影像的示意图。 图4示出了根据本公开一方面的划痕深度计算方案的示意图。 图5示出了根据本公开一方面的用于划痕深度测量的曲面误差补偿方案的示意图。 图6和图7分别示出了根据本公开一方面的划痕深度测量装置的分解视图和组装视图。 图8示出了根据本公开一方面的更加通用的划痕深度测量装置的框图。 图9示出了根据本公开一方面的划痕深度测量装置调节和测量方法的流程图。 具体实施方式 为了更好地理解本发明的技术方案,下面结合附图对本申请的实施例进行详细描述。 应当明确,所描述的实施例仅仅是本申请的一部分实施例,而不是全部的实施例的罗列。基于本公开中描述的实施例,本领域普通技术人员在没有付出创造习惯劳动的情况下所获得的所有其他变化例都属于本申请的保护范围。 图1示出了根据本公开一方面的划痕深度测量方案100的光路图。如图1中所示,在划痕深度测量方案100中,光源102发出光线,并经凸透镜104和106会聚后照射到挡片108上,形成半明半暗的图案。之后通过凹透镜110形成平行光束,并经过平面反射镜112反射后照射到机件的被测表面120的划痕122上。 入射的平行光线与机件的被测表面120形成角度α(与挡片同侧,未示出)。通过调节平面反射镜112改变角度α,就可以形成切入划痕的不同光切面。 图2示出了根据本公开的一方面的示意性光切面的示意图200。当因挡片造成半遮挡的平行光线时,明暗交界处形成光切面。该光切面与机件局部表面的交角(与挡片同侧)即为入射的平行光线与机件被测表面所形成的角度α。 图2中(a)示出了当角度α大于90°时的光切面示意图,图2中(b)示出了当角度α小于90°时的光切面示意图。 如所可知,机件表面可能并非平面,并且划痕可能并非是直线,其深浅也可能不一,但是当取机件局部表面时,可以近似地认为局部划痕大约为直线,且深浅一致。针对机件表面为曲面的改进将在下文中描述。 如所可见,由于光切面上的光线照射到划痕内部,因此经漫反射后可以在划痕的大致正上方观察到其在半明半暗影像的明暗分界线处形成底边在明暗分界线上的大致三角形(取决于划痕截面形状)的影像。当角度α大于90°时,例如,见图2的(a),则划痕影像为光亮的;而当角度α小于90°时,例如见图2的(b),则划痕影像为阴影的。 图3示出了根据本公开一方面的示意性划痕影像300的示意图。由于挡片遮挡了一半光线,因此形成了半明半暗的影像。在划痕处,由于平行光线以与机件被测表面成角度α(与挡片同侧)入射且α可小于90°或大于90°,因此可以形成大致为三角形的划痕影像。如图3的(a)中所示,当角度α大于90°时,形成光亮的三角形影像。如图3的(b)中所示,当角度α小于90°时,形成阴影的三角形影像。 基于从三角形影像的尖点到明暗分界线的距离以及角度α,便可以计算该处的划痕深度d。这将在以下结合附图4来进一步描述。 图4示出了根据本公开一方面的划痕深度计算方案400的示意图。图4的(a)中示出了平行光线以与被测表面成角度α(与挡片同侧)的方向射向划痕,其中角度α大于90°的情形。在划痕上方可观察到与图3中的(a)类似的划痕影像。图4的(b)中示出了平行光线以与被测表面成角度α(与挡片同侧)的方向射向划痕,其中角度α小于90°的情形。在划痕上方可观察到与图3中的(b)类似的划痕影像。 图4中为简化起见,将光线示意为在挡片之后直接照射到划痕上。但是根据以上对图1的描述可知,光线在经过挡片之后并非直接照射到划痕上,而是可以经过凹透镜并经平面反射镜反射后以与被测表面成角度α的方向照射到划痕上。 如所可见,由于光切面上的光线照射到划痕内部,因此经漫反射后可以通过划痕测量窗口在划痕的大致正上方观察到其在划痕位置处形成大致等腰三角形(取决于划痕截面形状)的影像。 通过确定划痕影像即等腰三角形的高度h,便可以计算出划痕的深度d。无论在图4的(a)还是(b)中,划痕的深度d均可按照下式(1)来计算: d=h×tanα。(1) 根据至少一些实施例,可以采用成像系统来采集并处理划痕的影像并相应测量。成像系统可以采集划痕影像并对相应等腰三角形的高度h进行像素计数等方式来确定高度h。成像系统可以包括但不限于例如cmos传感器相机等。 根据示例性方面,成像系统可以具有放大倍数k,从而划痕的深度d均可按照下式2来计算: d=(h/k)×tanα。(2) 图5示出了根据本公开一方面的用于划痕深度测量的曲面误差补偿方案500的示意图。 有时,被测表面并非完全平坦。例如,飞机的机件表面可能并非平面,而是可能构成曲面。在这种情况下,本公开提出了相应的修正方案。 如图5中(a)所示,当曲面为凸面时,需要将入射的平行光线与机件的被测表面形成的角度α减小θ。角度θ可基于被测表面的曲率半径r和支点之间的距离l来计算。例如,角度θ可按下式(3)近似计算为: arcsin(l/r)。(3) 由此,划痕的深度d可按照下式(4)来计算: d=h×tan(α–θ)=h×tan(α–arcsin(l/r))。(4) 另一方面,如图5中(b)所示,当曲面为凹面时,需要将入射的平行光线与机件的被测表面形成的角度α增大θ。角度θ可基于被测表面的曲率半径r和支点之间的距离l来计算。例如,角度θ可近似计算为arcsin(l/r)。由此,划痕的深度d可按照下式(5)来计算: d=h×tan(α+θ)=h×tan(α+arcsin(l/r))。(5) 由此,当被测表面并非平面时,可以基于被测表面的曲率半径r和支点之间的距离l,根据下式(6)来修正划痕深度d为: d=h×tan(α±θ)=h×tan(α±arcsin(l/r)),(6) 其中当曲面为凸面时,θ前取负号,而当曲面为凹面时,θ前取正号。 综上,当使用具有放大倍数k的成像系统,在支点之间的距离为l的情况下,以与被测表面成角度α的平行光线来检测曲率半径为r的曲面上的划痕深度时,划痕深度的计算公式可为式(7) d=(h/k)×tan(α±θ)=(h/k)×tan(α±arcsin(l/r)),(7) 其中当曲面为凸面时,θ和arcsin前取负号,而当曲面为凹面时,θ和arcsin前取正号。当被测表面为平面时,曲率半径r取正无穷。 图6和图7分别示出了根据本公开一方面的划痕深度测量装置的分解视图600和组装视图700。 如图6所示,划痕深度测量装置主要可包括凸透镜1(两块)、挡片2、凹透镜3、平面反射镜4、随动支架5、光源6、齿轮杆7、支撑件8、方向调节螺杆9、角度调节螺杆10、成像系统11、曲柄12、滑块13、壳体14,遮光布15、滑槽16、划痕观察窗口17、支点18等。 光路子系统可包括光源6、凸透镜1(两块)、挡片2、凹透镜3、平面反射镜4等。 凸透镜1可包括例如两面凸起的透镜,也可替换为其他凸透镜。 挡片2可包括不透光的半圆形板,其截面可包括锐角三角形。 凹透镜3可包括例如两面内凹的透镜,也可替换为其他凹透镜。 平面反射镜4可包括例如矩形镜面,也可替换为其他形状的镜面。 随动支架5可包括例如圆柱筒状或其他合适形状的结构以容纳支撑件8及其内的凸透镜1、凹透镜3及挡片2,以及容纳平面反射镜4等,并在圆柱筒底部具有带齿圆板。平面反射镜4被固定到齿轮杆7,齿轮杆被固定到随动支架5。 支撑件8可为空心圆柱筒结构,其顶部设有安装光源6的安装孔,在其内侧设有安装凸透镜1、凹透镜3及挡片2等的凹槽。 成像系统11可包括采用例如cmos传感器的相机及数据处理系统等。 壳体14可为大致长方形空心结构,其底部在成像系统11下方的位置设有用于观察划痕的矩形开口作为划痕观察窗口17,在顶部设有用于安装成像系统11和支撑件8的开口以及可供滑块13滑动的滑槽16,侧边设有用于安装方向调节螺杆9和角度调节螺杆10的开孔,其中角度调节螺杆10的开孔呈弧形。 遮光布15不透光且具有一定刚性,用于遮挡壳体上的开孔。 方向调节螺杆9可为柱状结构。特别地,在部分圆柱上设置了与随动支架5的带齿圆板相配合的丝杆。当调节方向调节螺杆9时,可带动随动支架5转动,可带动平面反射镜4在一定角度内平摇(即,在x-y平面上转动)。此时,由于齿轮杆7会发生一定随动,因此角度调节螺杆10可在弧形开口内移动。 齿轮杆7可为柱状结构,一端设有齿轮。特别地,齿轮杆7完成安装后与平面反射镜4可以无相对运动。 角度调节螺杆为10可为柱状结构。特别地,在部分圆柱上设置了与齿轮杆7相配合的丝杆,从而在转动角度调节螺杆10时,将带动齿轮杆7转动并带动平面反射镜4俯仰(即,在y-z平面上转动)。 曲柄12一端耦合到齿轮杆7上,另一端耦合到滑块13上。滑块13可沿滑槽16滑动。从而当转动角度调节螺杆10带动齿轮杆7转动时,齿轮杆7的转动导致曲柄12带动滑块13在滑槽16内滑动,以带动成像系统11移动,从而使得经平面反射镜4所反射的光线在被测表面上产生的影像始终在成像系统11的观察范围内。 当使用本申请的划痕深度测量装置时,可先将划痕观察窗口17置于机件的被测表面上。使得光源发出的光线经挡片2遮挡后通过平面反射镜4照射到处于划痕观察窗口17中的被测表面上并形成半明半暗的影像。通过方向调节螺杆9和角度调节螺杆10的配合调节,可以更准确地定位到被测表面上划痕并形成亮度合适的清晰影像。 成像系统11中的例如cmos传感器相机可采集被测表面漫反射的半明半暗影像,并由成像系统11中的数据处理系统对影像进行保存和处理。在需要的情况下,数据处理系统还可进行曲面补偿。最后,数据处理系统可以定量地给出划痕损伤深度的测量值。 图8示出了根据本公开一方面的更加通用的划痕深度测量装置800的框图。划痕深度测量装置800可以包括光路子系统802、调节子系统804以及成像子系统806等。 根据示例性实施例,光路子系统802可以产生用于以可调节的合适角度照射被测表面的半遮挡平行光线。例如,光路子系统802可以包括如以上结合图6和7描述的光源6、凸透镜1、挡片2、凹透镜3、平面反射镜4等。 调节子系统804可以用于调节光线照射被测表面的角度以及位置,以便于更准确地定位到被测表面上划痕的影像。例如,调节子系统804可以包括如以上结合图6和7描述的随动支架5、齿轮杆7、方向调节螺杆9、角度调节螺杆10、曲柄12、滑块13等。 成像子系统806可以用于获取、存储和处理被测表面的影像,并定量地给出划痕损伤深度的测量值等。例如,成像子系统806可以包括以上结合图6和7描述的成像系统11等。成像子系统806可以相应地包括影像采集部分和数据处理部分。影像采集部分可以包括例如cmos传感器相机。数据处理部分可以包括例如各种专用或通用计算机处理器等。 图9示出了根据本公开一方面的划痕深度测量装置调节和测量方法900的流程图。方法900主要可以包括装置粗调902、装置精调904、图像采集906及数据处理908等四个部分,具体如下。 装置粗调步骤902可包括:将该划痕深度测量装置放置于被测表面。打开光源。光源产生的光线通过光路子系统(例如,图8的框802等)后照射在被测表面上形成半明半暗的影像。 例如,根据一示例性实施例,光源产生的光线通过两个凸透镜会聚后照射到挡片上被遮挡一半光线,再通过凹透镜形成平行光束并通过折射镜照射到划痕上形成半明半暗的影像。可以调整划痕深度测量装置摆放位置使得其正好位于划痕的上方。一般而言,划痕深度测量装置的中轴线与划痕方向所成角度不受特别限制,且其也可通过方向调节来调整。 装置精调步骤904可包括:通过对调节子系统(例如,图8的框804等)进行调节,可以更准确地定位到被测表面上划痕并形成亮度合适的清晰影像。 例如,根据一示例性实施例,可以转动角度调节螺栓,使得齿轮杆绕轴中心线旋转。由于折射镜与齿轮杆相对静止,折射镜同时绕齿轮杆的轴中心线在y-z平面旋转,从而改变光线的射入角度,使得成像系统中的成像亮度最为合适,此角度即为最佳光线射入角度α。另一方面,可转动方向调节螺杆,使得待测点的图像完全在成像系统的视界中。 图像采集步骤906可包括:通过成像子系统(例如,图8的框806等)中的影像采集部分采集被测表面漫反射的半明半暗影像。当被测表面上有划痕时,该半明半暗影像上将如图3中所示类似地呈现与划痕对应的三角形影像。 影像采集部分可包括但不限于例如cmos传感器相机等。 数据处理步骤908可包括:通过成像子系统(例如,图8的框806等)中的数据处理系统对所采集的半明半暗影像进行处理,计算出划痕深度,如以上结合图4以及式(1)、(2)等所描述。 根据进一步的实施例,在例如飞机制造等领域,经常会遇到被测表面为曲面的情况。为了对划痕在曲面上的测量误差进行补偿,数据处理系统可根据被测表面的曲率半径对测量误差进行补偿,如以上结合图5以及式(3)–(7)中任一者所述。 在例如飞机制造等领域,由于特定型号的飞机其表面曲率半径一般是已知的,因此可以手动输入曲率半径来使得数据处理系统对测量误差进行相应补偿。根据其他实施例,曲率半径也可被预存在数据处理系统中或通过其他方式从外部获得。根据另外的实施例,曲率半径可通过例如该划痕深度测量装置内置或外附的曲率半径测量仪等来获得,并通过自动或手动的方式提供给该划痕深度测量装置用于对划痕深度测量误差进行补偿。 以上所述的仅为本发明的示例性具体实施例。但本发明的保护范围并不局限于此。任何熟悉本技术领域的技术人员在本发明揭露的技术范围内,可轻易想到的变化或替换,都应涵盖在本发明的保护范围之内。 将理解,权利要求并不被限于以上所解说的精确配置和组件。可在以上所描述的方法和装置的布局、操作和细节上做出各种改动、更换和变形而不会脱离权利要求的范围。 |
【本文地址】
今日新闻 |
推荐新闻 |