垂直DMOSFET及其制备方法、BCD器件与流程 |
您所在的位置:网站首页 › vdmosfet的全称 › 垂直DMOSFET及其制备方法、BCD器件与流程 |
垂直DMOSFET及其制备方法、BCD器件与流程
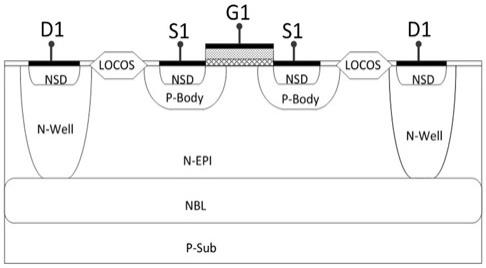 垂直dmosfet及其制备方法、bcd器件技术领域1.本发明涉及单片集成工艺技术领域,具体涉及一种与bcd工艺兼容耐压可选的垂直dmosfet及其制备方法、bcd器件。 垂直dmosfet及其制备方法、bcd器件技术领域1.本发明涉及单片集成工艺技术领域,具体涉及一种与bcd工艺兼容耐压可选的垂直dmosfet及其制备方法、bcd器件。背景技术: 2.bcd(bipolar‑cmos‑dmos)集成工艺是一种单片集成工艺技术,将bipolar(双极晶体管)、cmos(互补金属氧化物半导体场效应管)和dmosfet(双扩散金属氧化物半导体场效应管)器件同时制作在同一芯片上。它综合了各器件自身的优点,使其具有各自分立时的良好性能。整合过的bcd工艺可大幅降低功率耗损,提高系统性能,节省成本,可靠性更好。其中,dmosfet器件是由成百上千的单一结构的dmosfet单元所组成的,这些单元的数目是根据一个芯片所需要的驱动能力所决定的,dmosfet的性能直接决定了芯片的驱动能力和芯片面积。dmosfet的主要技术指标有:耐压、导通电阻、阈值电压等。3.dmosfet主要有两种类型:横向双扩散金属氧化物半导体场效应管ldmosfet和垂直双扩散金属氧化物半导体场效应管vdmosfet。其中,vdmosfet的耐压非常高,但由于是纵向结构,漏极从晶圆背面引出,不适合与平面结构的集成电路相结合。因此,bcd中的高压器件常采用的是ldmosfet。但是,由于ldmosfet要达到很高的耐压时,结构中需要设计漂移区(漂移区的杂质浓度比较低),使得漏极区占有很大的面积,同时也会造成器件的导通电阻增加。 技术实现要素: 4.本发明的目的是解决现有ldmosfet漏极区占用面积大、导通电阻较大以及vdmosfet兼容性较差的问题,提供一种垂直dmosfet及其制备方法、bcd器件。5.为实现上述目的,本发明采用以下技术方案:一种垂直dmosfet,包括p型衬底;在所述p型衬底上表面形成的nbl埋藏层,所述nbl埋藏层的注入离子为n型离子;在所述nbl埋藏层上表面形成的n型外延层;在所述n型外延层上表面通过局部氧化隔离形成的氧化层;所述n型外延层内依次设有n‑well区和p‑body区;所述n‑well区的上表面设置有n+接触区,形成漏极,所述n‑well区的底端与nbl埋藏层相连通;所述p‑body区的上表面设置有n+接触区,形成源极;所述n型外延层的上表面自下至上依次设置有栅氧化层和多晶硅层,形成栅极,所述多晶硅层和栅氧化层位于p‑body区上表面n+接触区的一侧,且部分覆盖p‑body区上表面。6.进一步地,所述垂直dmosfet的导通电阻通过调节n‑well区的离子注入剂量控制。7.进一步地,所述nbl埋藏层的注入离子为砷或锑,所述n‑well区的注入离子为磷,所述p‑body区的注入离子为硼,所述n+接触区的注入离子为砷。8.上述垂直dmosfet的制备方法包括以下步骤:步骤一、选取晶向为;100;的p型衬底,利用n型埋藏层光罩,通过光刻工艺形成nbl埋藏层,并对此区域进行n型离子注入,随后对nbl埋藏层进行1000~1150℃的高温炉管推结;在nbl埋藏层上表面生长n型外延层,在n型外延层上进行局部氧化工艺,实现局部氧化隔离,形成厚度为8000~9000埃的氧化层;步骤二、利用n‑well的光罩,通过光刻工艺在n型外延层内形成n‑well区,对其进行离子注入,通过离子的注入能量和注入剂量确保n‑well区注入的离子与nbl埋藏层连通;步骤三、在n型外延层上生长500~600埃的栅氧化层,并在栅氧化层上淀积6500~7500埃的多晶硅层,利用栅极的光罩,通过光刻工艺定义出栅极区域,并对栅极区域的多晶硅层进行刻蚀,将其回刻到3500~4500埃,形成栅极;步骤四、利用p‑body的光罩定义出p‑body区,采用自对准大角度的注入工艺对p‑body区进行离子注入;步骤五、在p‑body区及n‑well区域进行n+注入,形成n+接触区,引出源极和漏极;步骤六、形成中间介质层、接触孔和金属层。9.进一步地,步骤二中,n‑well区的注入离子为磷,注入能量为75kev~100kev,注入剂量为1.0e14cm‑2~1.5e14cm‑2;步骤四中,p‑body区的注入离子为硼,注入的斜角角度为35~45度,采用四次旋转注入,注入能量为40kev~55kev,注入剂量为2.5e13 cm‑2~3e13cm‑2;步骤五中,n+接触区的注入离子为砷,注入能量为70kev~80kev,注入剂量为7.5e15cm‑2~8e15cm‑2。10.本发明还提供另一种垂直dmosfet,包括p型衬底;在所述p型衬底上表面形成的nbl埋藏层,所述nbl埋藏层的注入离子为n型离子;在所述nbl埋藏层的上表面自下至上依次形成的m个n型外延层,m≥2,m个n型外延层的离子掺杂浓度自下至上依次递增;在第m个n型外延层上表面通过局部氧化隔离形成的氧化层;所述第m个n型外延层内依次设有n‑well区和p‑body区;所述n‑well区的上表面设置有n+接触区,形成漏极,所述n‑well区的底端依次通过m‑1个nbl埋藏区与nbl埋藏层相连通;所述p‑body区的上表面设置有n+接触区,形成源极;所述n型外延层的上表面自下至上依次设置有栅氧化层和多晶硅层,形成栅极,所述多晶硅层栅氧化层位于p‑body区上表面n+接触区的一侧,且部分覆盖p‑body区的上表面。11.进一步地,所述垂直dmosfet的导通电阻通过调节n‑well区的离子注入剂量控制。12.进一步地,所述nbl埋藏层的注入离子为砷或锑,所述n‑well区的注入离子为磷,所述p‑body区的注入离子为硼,所述n+接触区的注入离子为砷。13.上述垂直dmosfet的制备方法包括以下步骤:步骤一、选取晶向为;100;的p型衬底,利用n型埋藏层光罩,通过光刻工艺形成nbl埋藏层,并对此区域进行n型离子注入,随后对nbl埋藏层进行1000~1150℃的高温炉管推结;在nbl埋藏层上表面生长n型外延层,利用n‑well光罩,在该n型外延层形成nbl埋藏区,对nbl埋藏区进行n型离子注入并进行高温推结,重复该过程多次,直至形成m个n型外延层和m‑1个依次连接的nbl埋藏区;在第m个n型外延层上进行局部氧化工艺,实现局部氧化隔离,形成厚度为8000~9000埃的氧化层;步骤二、利用n‑well的光罩,通过光刻工艺在第m个n型外延层内且对应第m‑1个nbl埋藏区位置形成n‑well区,对其进行离子注入,通过离子的注入能量和注入剂量确保n‑well区注入的离子通过m‑1个nbl埋藏区与nbl埋藏层相连通;步骤三、在第m个n型外延层生长500~600埃的栅氧化层,并在栅氧化层上淀积6500~7500埃的多晶硅层,利用栅极的光罩,通过光刻工艺定义出栅极区域,并对栅极区域的多晶硅层进行刻蚀,将其回刻到3500~4500埃,形成栅极;步骤四、利用p‑body的光罩定义出p‑body区,采用自对准大角度的注入工艺对p‑body区进行离子注入;步骤五、在p‑body区及n‑well区域进行n+注入,形成n+接触区,引出源极和漏极;步骤六、形成中间介质层、接触孔和金属层。14.进一步地,步骤二中,n‑well区的注入离子为磷,注入能量为75kev~100kev,注入剂量为1.0e14cm‑2~1.5e14cm‑2;步骤四中,p‑body区的注入离子为硼,注入的斜角角度为35~45度,采用四次旋转注入,注入能量为40kev~55kev,注入剂量为2.5e13cm‑2~3e13cm‑2;步骤五中,n+接触区的注入离子为砷,注入能量为70kev~80kev,注入剂量为7.5e15cm‑2~8e15cm‑2。15.本发明还提供了一种bcd器件,包括双极晶体管、cmos和上述垂直dmosfet,所述双极晶体管、cmos和垂直dmosfet共用衬底层、埋藏层和外延层。16.与现有技术相比,本发明具有如下有益效果:1.本发明提出一种与bcd集成工艺兼容的垂直dmosfet,其漏极是bcd工艺中的n型埋层,通过深n阱n‑well区将其从正面引出。在相同耐压下,此结构不仅可以减小芯片面积,提高芯片利用率,同时通过调节n‑well区的离子掺杂浓度还可减小导通电阻。另外,此结构的工艺只需增加n‑well区的光罩,通过光刻和离子注入工艺来实现漏极引出,工艺相对成熟,易实现。17.2.本发明垂直dmosfet设置有多层n型外延层,n型外延层的电阻率由下至上依次递减,该垂直dmosfet采用多次外延、参数递变的方法实现了垂直dmosfet与bcd器件的兼容,通过调节第m个n型外延层的参数使其满足bcd器件的电性要求,调节剩余n型外延层的参数使得满足垂直dmosfet器件的电性要求。附图说明18.图1为本发明实施例一的双垂直dmosfet结构示意图;图2为本发明实施例二的双垂直dmosfet结构示意图;图3为本发明实施例三的双垂直dmosfet结构示意图;图4为本发明实施例一垂直dmosfet制备方法中步骤一的示意图;图5为本发明实施例一垂直dmosfet制备方法中步骤二示意图;图6为本发明实施例一垂直dmosfet制备方法中步骤三示意图;图7为本发明实施例一垂直dmosfet制备方法中步骤四示意图;图8为本发明实施例一垂直dmosfet制备方法中步骤五示意图;图9为本发明实施例一垂直dmosfet制备方法中步骤六示意图;图10为本发明实施例二垂直dmosfet制备方法中步骤一的示意图;图11为本发明实施例三垂直dmosfet制备方法中步骤一的示意图;图12为本发明实施例四的bcd器件结构示意图。具体实施方式19.下面结合附图和具体实施方式对本发明进行详细说明。本领域技术人员应当理解的是,这些实施方式仅仅用来解释本发明的技术原理,目的并不是用来限制本发明的保护范围。20.本发明提出一种与bcd集成工艺兼容的垂直dmosfet,其漏极是bcd工艺中的n型埋层,通过n型阱将其从正面引出。在相同耐压下,此结构不仅可以减小芯片面积,提高芯片利用率,同时可通过调节n型阱的掺杂浓度来控制器件的导通电阻。21.图1至图3所示均为垂直dmosfet器件的结构,图中均是以平面dmosfet为例,当然也可为沟槽dmosfet、超结dmosfet等结构;隔离区采用的是与bcd中cmos器件兼容的locos场氧隔离,也可以采用与dmosfet器件兼容的p型离子注入的分压环隔离。图中,g1为dmosfet器件的栅极,d1为dmosfet器件的漏极,s1为dmosfet器件的源极。22.实施例一本实施例提供垂直dmosfet与bcd中器件的耐压相当(差值≤10v),如图1所示,为双垂直dmosfet的外延参数:电阻率/厚度与bcd器件一致时,可采用一次外延方法。通过n型阱与nbl埋藏层连接,将其垂直dmosfet器件的漏极从晶圆正面引出。此结构的工艺只需增加n型阱的光罩,通过光刻和离子注入工艺来实现漏极引出,工艺相对成熟,易实现。氧化层的隔离区采用的是与bcd中cmos器件兼容的locos场氧隔离,也可以采用与dmosfet器件兼容的p型离子注入的分压环隔离。本实施例提供的垂直dmosfet结构具体如下,包括:p型衬底;在p型衬底上表面形成的nbl埋藏层,nbl埋藏层的注入离子为n型离子;在nbl埋藏层上表面形成的n型外延层;在n型外延层上表面通过局部氧化隔离形成的氧化层;n型外延层内依次设有n‑well区和p‑body区;n‑well区的上表面设置有n+接触区,形成漏极,n‑well区的底端与nbl埋藏层相连通;p‑body区的上表面设置有n+接触区,形成源极;n型外延层的上表面自下至上依次设置有栅氧化层和多晶硅层,形成栅极,多晶硅层和栅氧化层位于p‑body区上表面n+接触区的一侧,且部分覆盖p‑body区上表面。23.本实施例提供的垂直dmosfet的制备方法如下:步骤一、选取晶向为;100;的p型衬底,利用n型埋藏层光罩,通过光刻工艺形成nbl埋藏层,并对此区域进行n型离子注入,注入离子可为砷或锑,随后对nbl埋藏层进行1000~1150℃的高温炉管推结;在nbl埋藏层上表面生长一层5~6um的n型外延层,在n型外延层上进行局部氧化工艺,实现locos局部氧化隔离,形成厚度为8000~9000埃的氧化层,如图4所示;步骤二、利用n‑well的光罩,通过光刻工艺在n型外延层内形成n‑well区,对其进行磷离子注入,离子注入的能量为75kev~100kev,离子注入的剂量为1.0e14cm‑2~1.5e14cm‑2,确保其与nbl埋藏层连通,如图5所示;步骤三、在n型外延层上生长500~600埃的栅氧化层,在栅氧化层上淀积6500~7500埃的多晶硅层,利用栅极的光罩,通过光刻工艺定义出栅极区域,并对栅极区域的多晶硅层进行刻蚀,将其回刻到3500~4500埃,形成栅极,如图6所示;步骤四、利用p‑body的光罩定义出p‑body区,采用自对准大角度的注入工艺对p‑body进行硼离子注入,注入能量约为40kev~55kev,注入剂量约为2.5e13cm‑2~3e13cm‑2,p‑body注入角度及注入剂量均可与bcd 工艺相兼容,且注入的斜角角度为35~45度,可采用四次旋转注入,确保p‑body的注入位置准确,如图7所示;步骤五、在p‑body区及n‑well区进行n+注入,形成n+接触区,引出源极和漏极,此工艺与bcd工艺相兼容,其注入离子为砷,注入能量约为70kev~80kev,注入剂量约为7.5e15cm‑2~8e15cm‑2,如图8所示;步骤六、后续的工艺为常规工艺,如中间介质层、接触孔和金属层的形成等,完成dmosfet器件的所有工艺,如图9所示。24.实施例二本实施例提供的垂直dmosfet器件的耐压稍大于bcd中器件的耐压(10v<差值≤60v),如图2所示,为双垂直dmosfet器件的外延参数:电阻率/厚度稍大于bcd器件时,可采用双层外延的方法来实现。通过调节外延层n‑epi2的参数满足bcd器件的电性要求,调节n‑epi1的电阻率递增,综合n‑epi1和n‑epi2满足垂直dmosfet器件的电性参数要求。由于双层外延的电阻率不同,n‑well通过一次离子注入形成,在两层外延中的分布有差。因此,可通过多次工艺实现,利用n型阱的光罩,在n‑epi1中做n型埋层nbl1,在n‑epi2中形成n型阱n‑well。此结构中漏极的n型阱采用两次工艺,但共用一张光罩。此结构中增加的工艺均为成熟工艺的重复应用,因此,不会增加工艺难度。本实施例提供的垂直dmosfet结构具体如下,包括:p型衬底;在p型衬底上表面形成的nbl埋藏层,nbl埋藏层的注入离子为n型离子;在nbl埋藏层上表面自下至上依次形成的2个n型外延层,即n‑epi1和n‑epi2,n‑epi2的电阻率小于n‑epi1的电阻率,即n‑epi2的离子掺杂浓度大于n‑epi1的离子掺杂浓度;在第2个n型外延层n‑epi2上表面通过局部氧化隔离形成的氧化层;第2个n型外延层内依次设有n‑well区和p‑body区;n‑well区的上表面设置有n+接触区,形成漏极,n‑well区的底端通过nbl1埋藏区与nbl埋藏层相连通;p‑body区的上表面设置有n+接触区,形成源极;n型外延层的上表面自下至上依次设置有栅氧化层和多晶硅层,形成栅极,多晶硅层栅氧化层位于p‑body区上表面n+接触区的一侧,且部分覆盖p‑body区的上表面。25.该实施例的垂直dmosfet的制备方法如下:步骤一、选取晶向为;100;的p型衬底,利用n型埋藏层光罩,通过光刻工艺形成nbl埋藏层,并对此区域进行n型离子注入,注入离子可为砷或锑,随后对nbl埋藏层进行1000~1150℃的高温炉管推结;在nbl埋藏层上表面生长一层4~5um的n型外延层n‑epi1,利用n‑well光罩,在n‑epi1内形成nbl1埋藏区,对其进行n型离子注入并进行高温推结,确保其与nbl埋藏层连通;再生长一层3~4um的n型外延层n‑epi2;在n型外延层n‑epi2上进行局部氧化工艺,实现locos局部氧化隔离,形成厚度为8000~9000埃的氧化层,如图10所示;步骤二、利用n‑well的光罩,通过光刻工艺在n‑epi2上形成n‑well区,对其进行n‑well离子注入,确保其与nbl1埋藏层连通,注入的离子为磷,注入的能量为75kev~100kev,离子注入的剂量为1.0e14cm‑2~1.5e14cm‑2;步骤三、在第2个n型外延层上生长500~600埃的栅氧化层,在其上淀积6500~7500埃的多晶硅层,利用栅极的光罩,通过光刻工艺定义出栅极区域,并对栅极区域的多晶硅层进行刻蚀,将其回刻到3500~4500埃,形成栅极;步骤四、利用p‑body的光罩定义出p‑body区,采用自对准大角度的注入工艺对p‑body进行硼离子注入;注入能量约为40kev~55kev,注入剂量约为2.5e13cm‑2~3e13cm‑2,p‑body注入角度及注入剂量均可与bcd 工艺相兼容,且注入的斜角角度为35~45度,可采用四次旋转注入,确保p‑body的注入位置准确;步骤五、在p‑body区域及n‑well区域进行n+注入,形成n+接触区,引出源极和漏极,此工艺与bcd工艺相兼容,其注入离子为砷,注入能量约为70kev~80kev,注入剂量约为7.5e15cm‑2~8e15cm‑2,与bcd工艺兼容;步骤六、后续的工艺为常规工艺,如中间介质层、接触孔和金属层的形成等,完成dmosfet器件的所有工艺。26.实施例三本实施例提供的垂直dmosfet器件的耐压远大于bcd中器件的耐压(差值>60v),如图3所示,为双垂直dmosfet器件的外延参数:电阻率/厚度远大于bcd器件时,可以采用多层外延方法。由于垂直dmosfet器件与bcd器件的耐压相差较大,则两者的外延参数相差较大,因此,需要采用多次外延、参数递变的方法来实现两者外延的兼容性。通过调节外延层n‑epim(m≥3)的参数使其满足bcd器件的电性要求,综合调节剩余外延层n‑epi1~n‑epi(m‑1)的参数使得满足垂直dmosfet器件的电性要求。同样的,由于多次外延的厚度较厚,且各外延层的电阻率有差,导致n型阱的深度较深,且相同工艺条件在各外延层中的分布有差,增加了工艺难度的同时,工艺效果无法保证。因此,n型阱需要多次工艺实现,利用同一张光罩n‑well,在n‑epim外延层形成n型阱,其他外延层做埋层nbl1~nbl(m‑1)。此结构中的工艺也为重复的成熟工艺,易实现。本实施例提供的垂直dmosfet结构具体如下,包括:包括p型衬底;在p型衬底上表面形成的nbl埋藏层,nbl埋藏层的注入离子为n型离子;在nbl埋藏层的上表面自下至上依次形成的m个n型外延层,m≥3,m个n型外延层的离子掺杂浓度自下至上依次递增,使得n型外延层的电阻率自下至上依次递减;在第m个n型外延层上表面通过局部氧化隔离形成的氧化层;第m个n型外延层内依次设有n‑well区和p‑body区;n‑well区的上表面设置有n+接触区,形成漏极,n‑well区的底端依次通过m‑1个nbl埋藏区与nbl埋藏层相连通;p‑body区的上表面设置有n+接触区,形成源极;n型外延层的上表面自下至上依次设置有栅氧化层和多晶硅层,形成栅极,多晶硅层栅氧化层位于p‑body区上表面n+接触区的一侧,且部分覆盖p‑body区的上表面。27.本实施例提供的垂直dmosfet的制备方法如下:步骤一、选取晶向为;100;的p型衬底,利用n型埋藏层光罩,通过光刻工艺形成nbl埋藏层,并对此区域进行n型离子注入,注入离子可为砷或锑,随后对nbl埋藏层进行1000~1150℃的高温炉管推结;在nbl埋藏层上表面生长一层4~5um的n型外延层n‑epi1,利用n‑well光罩,在n‑epi1形成nbl1埋藏区,对其进行n型离子注入并进行高温推结,多次重复此工艺,形成n型外延层n‑epi2~n‑epim和nbl埋藏区nbl1~nbl(m‑1),确保各埋层之间的连通;最后生长n型外延层n‑epim,在其上进行局部氧化工艺,实现locos局部氧化隔离,其氧化层厚度为8000~9000埃,如图11所示;步骤二、利用n‑well的光罩,通过光刻工艺在n型延层n‑epim上形成n‑well区,对其进行n‑well离子注入,确保其与nbl(m‑1)埋藏区连通,注入的离子为磷,注入的能量为75 kev ~100kev,离子注入的剂量为1.0e14cm‑2~1.5e14cm‑2;步骤三、生长500~600埃的栅氧化层,在其上淀积6500~7500埃的多晶硅层,利用栅极的光罩,通过光刻工艺定义出栅极区域,并对栅极区域的多晶硅层进行刻蚀,将其回刻到3500~4500埃,形成栅极;步骤四、利用p‑body的光罩定义出p‑body区,采用自对准大角度的注入工艺对p‑body进行硼离子注入,注入能量约为40kev ~55kev,注入剂量约为2.5e13cm‑2~3e13cm‑2;其中,p‑body注入角度及注入剂量均可与bcd 工艺相兼容,且注入的斜角角度为35~45度,可采用四次旋转注入,确保p‑body的注入位置准确;步骤五、在p‑body区域及n‑well区域进行n+注入,形成n+接触区,引出源极和漏极,此工艺与bcd工艺相兼容。其注入离子为砷,注入能量约为70kev ~80kev,注入剂量约为7.5e15cm‑2~8e15cm‑2,与bcd工艺兼容;步骤六、后续的工艺为常规工艺,如中间介质层、接触孔和金属层的形成等,完成dmosfet器件的所有工艺。28.实施例四与实施例一垂直dmosfet兼容的bcd器件的结构如图12所示,其中,p‑sub衬底和nbl埋藏层为传统bcd器件的所用层次,nbl埋藏层的主要作用是降低cmos器件的漏极电阻,同时也可与n‑well连通引出dmosfet的漏极,而dmosfet的漏极电阻主要是通过调节n‑well的浓度来实现。(n‑well和bcd中的n‑well工艺条件相同的情况下可同时实现,为了方便单独控制dmosfet的漏极,可设定为两个层次)。此结构应用到bcd器件中,只有n‑well为单独工艺,其他工艺基本均可与bcd器件兼容。图12中,g1为dmosfet器件的栅极;d1为dmosfet器件的漏极;s1为dmosfet器件的源极;g2为cmos中pmos器件的栅极;d2为cmos中pmos器件的漏极;s2为cmos中pmos器件的源极;g3为cmos中nmos器件的栅极;d3为cmos中nmos器件的漏极;s3为cmos中nmos器件的源极。 |
【本文地址】