电子元器件 IC封装 (IC 类) |
您所在的位置:网站首页 › ic引脚形状有哪几种 › 电子元器件 IC封装 (IC 类) |
电子元器件 IC封装 (IC 类)
封装指芯片 ( Die) 和不同类型的框架 (L/F) 和塑封料 (EMC)形成的不同外形的封装体.按装材料划分为 : 金属封装 、陶瓷封装、塑料封装。按连接方式分为: PTH封装、SMT封装。按封装外型分为: SOT、SOIC、TSSOP、QFN、QFP、BGA、CSP等。IC的封装形式思维导图 IC的封装形式封装介绍SOT (Small Outline Transistor)小外型晶体管 IC的封装形式封装介绍SOT (Small Outline Transistor)小外型晶体管小外形晶体管(SOT) 是一系列小尺寸、分立式表面贴装 晶体管,通常用于消费电子产品。最常见的 SOT 是 SOT23 变体,制造商还提供几乎相同的薄小外形晶体管(TSOT) 封装,其中较低的高度很重要。  SOT封装 SOT封装SOT23-3 封装非常流行,是晶体管的常用封装,也用于二极管和稳压器。  SOT23-3封装 SOT23-3封装SOT223-4 封装是一种流行的稳压器封装。它是由飞利浦推出的。  SOT223-4封装 SOT223-4封装SOT223-8 封装是一种流行的桥接四晶体管封装。  SOT223-8封装 SOT223-8封装SOT23-5(SOT25、SC74A、SOT753、MO-178AA、SMT5)、SOT353(SC70-5、SC88A、TSSOP-5、UMT5)、SOT553 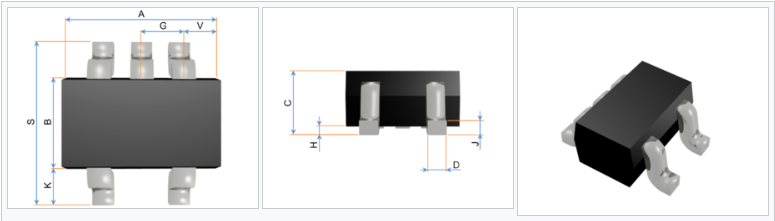 SOT23-5/SOT353/SOT553封装 SOT23-5/SOT353/SOT553封装SOT23-6 (SOT26, SC59-6, SC74, TSOP-6, MO-178AB, SMT6, SM6, Mini6, SOT457),SOT363 (SC70-6, SC88, TSSOP-6, UMT6, US6, S-Mini6),SOT563 (SC-107C, ES6)  SOT23-6/SOT363/SOT563封装 SOT23-6/SOT363/SOT563封装SOT23-8 (SOT28)  SOT23-8封装 SOT23-8封装SOT143 (TO253), SOT343  SOT143/SOT343封装 SOT143/SOT343封装SOT490(SOT523F、SC89、EMT3F) 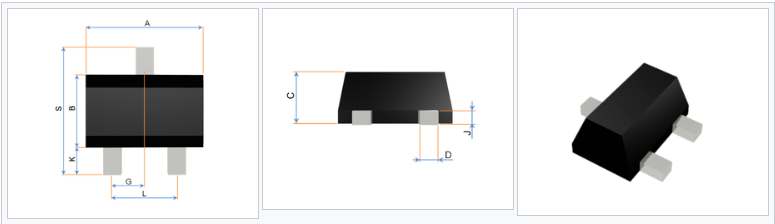 SOT490封装 SOT490封装SOT89-3 在电气上只有三个引线(触点/引脚)。宽引线(标签)实际上是封装另一侧中间引线的一部分。有人称此封装为 SOT89-4,因为当俯视该器件时,它在视觉上似乎有四个引线。  SOT89-3封装 SOT89-3封装SOT89-5 在电气上只有五个引线(触点/引脚)。中间引线实际上是封装另一侧中间引线的一部分。有人称此封装为 SOT89-6,因为当俯视该器件时,它在视觉上似乎有六个引线。  SOT89-5封装SOIC (small out-line integrated circuit)SOP的别称 SOT89-5封装SOIC (small out-line integrated circuit)SOP的别称小外形集成电路( SOIC ) 是一种表面贴装 集成电路(IC) 封装,其占用面积比等效双列直插式封装(DIP) 少 30-50%,典型厚度少 70%。它们通常与对应的 DIP IC具有相同的引出线。命名封装的约定是SOIC或SO后跟引脚数。例如,14 针4011将采用 SOIC-14 或 SO-14 封装。  SOIC封装 SOIC封装SOIC (JEDEC) SOIC 窄封装的一般形状和主要尺寸。表中显示了常见 SOIC 的这些尺寸值(以毫米为单位)  SOIC封装主要尺寸 SOIC封装主要尺寸收缩小外形封装 (SSOP) 收缩小外形封装 (SSOP) 芯片具有从两个长边突出的“鸥翼”引线,引线间距为 0.0256 英寸(0.65 毫米)或 0.025 英寸(0.635 毫米)。[4] 0.5 毫米的引线间距不太常见,但并不罕见。 压缩 SOP 的主体尺寸并收紧引线间距以获得更小版本的 SOP。与标准封装相比,这产生了尺寸显着减小的 IC 封装。所有 IC 组装过程都与标准 SOP 相同。 SSOP 的应用使最终产品(寻呼机、便携式音频/视频、磁盘驱动器、收音机、RF 设备/组件、电信)的尺寸和质量得以减小。SSOP 产品系列很好地解决了使用 BiCMOS、CMOS 或其他硅/GaAs 技术的半导体系列,例如运算放大器、驱动器、光电、控制器、逻辑、模拟、存储器、比较器等。  SSOP封装 SSOP封装薄型小外形封装 (TSOP) 薄型小外形封装( TSOP) 是一种矩形薄体组件。I 型 TSOP 的腿从封装的宽度部分突出。II 型 TSOP 的腿从封装的长度部分突出。DRAM 内存模块上的 IC通常是 TSOP,直到它们被球栅阵列(BGA) 取代。  TSOP封装 TSOP封装薄缩小外形封装 (TSSOP) 薄收缩小外形封装 (TSSOP)是一种矩形薄体组件。TSSOP 的分支数范围为 8 到 64。TSSOP 特别适用于栅极驱动器、控制器、无线/ RF、运算放大器、逻辑、模拟、ASIC、存储器(EPROM、E2PROM)、比较器和光电子产品。建议将内存模块、磁盘驱动器、可刻录光盘、电话听筒、快速拨号器、视频/音频和消费电子产品/电器用于 TSSOP 封装。  TSSOP封装TSSOP (Thin Shrink Small Outline Package)薄的缩小型SOP TSSOP封装TSSOP (Thin Shrink Small Outline Package)薄的缩小型SOP薄型收缩小外形封装 (TSSOP)是一种带有鸥翼引线 的矩形表面贴装塑料集成电路(IC) 封装。 它们适用于需要 1 毫米或更小安装高度的应用,通常用于模拟和运算放大器、控制器和驱动器、逻辑、存储器和射频/无线、磁盘驱动器、视频/音频和消费电子产品。 与标准SOIC封装相比,Thin shrink small outline 封装具有更小的主体和更小的引线间距。它也比具有相同引脚数的TSOP更小更薄。主体宽度为 3.0 毫米、4.4 毫米和 6.1 毫米。引线数范围为 8 至 80 针。引线间距为 0.5 或 0.65 mm。 一些 TSSOP 封装有一个裸焊盘。这是封装底部的矩形金属焊盘。裸露的焊盘将焊接在pcb上,以将热量从封装传递到 pcb。在大多数应用中,裸露焊盘接地。 HTSSOP 散热器薄收缩小外形封装(HTSSOP) 是德州仪器(TI)对底部带有裸露焊盘的 TSSOP 的名称。还有一些其他制造商使用相同的名称。  HTSSOP封装QFN (quad flat non-leaded package)四侧无引脚扁平封装 HTSSOP封装QFN (quad flat non-leaded package)四侧无引脚扁平封装四方扁平无引线( QFN ) 和双扁平无引线( DFN ) 等扁平无引线封装将集成电路与印刷电路板进行物理和电气连接。扁平无引线,也称为微型引线框 (MLF) 和 SON(小轮廓无引线),是一种表面贴装技术,是将IC连接到PCB表面而无需通孔的几种封装技术之一。扁平无引线是一种接近芯片级的塑料封装封装,由平面铜制成引线框架基板。封装底部的周边焊盘提供与PCB的电气连接。扁平无铅封装通常(但并非总是)包括一个裸露的导热垫,以改善从IC传出(进入 PCB)的热传递。导热垫中的金属通孔可以进一步促进热传递。QFN 封装类似于四方扁平封装(QFP) 和球栅阵列(BGA)。  QFN封装 QFN封装该封装具有多种优势,包括降低引线电感、小尺寸“近芯片级”占位面积、薄型和低重量。它还使用周边 I/O 焊盘来简化 PCB 走线布线,并且裸露的铜芯片焊盘技术提供了良好的热性能和电气性能。这些特性使 QFN 成为许多对尺寸、重量以及热性能和电气性能很重要的新应用的理想选择。 QFN 封装类似于四方扁平封装,但引线不从封装侧面伸出。因此很难手工焊接 QFN 封装、检查焊点质量或探针引线。 不同的制造商对QFN使用名称对应表 不同的制造商对QFN使用不同的名称:ML(微型引线框)与 FN(扁平无引线),此外还有所有四个侧面都有焊盘(四边形)和两个侧面都有焊盘(双面)的版本,厚度各不相同正常封装在 0.9–1.0 毫米之间,极薄封装在 0.4 毫米之间。缩写包括:  不同的制造商对QFN使用名称对应表 不同的制造商对QFN使用名称对应表微型引线框架封装(MLP) 微型引线框架封装(MLP) 是集成电路QFN 封装系列,用于表面贴装 电子电路设计。它有 3 个版本,分别是 MLPQ(Q 代表四通道)、MLPM(M 代表微型)和 MLPD(D 代表双通道)。这些封装通常有一个裸露的芯片连接垫,以提高热性能。该封装在结构上类似于芯片级封装(CSP)。MLPD 旨在为小外形集成电路(SOIC) 封装提供足迹兼容的替代品。  MLP封装 MLP封装微型引线框(MLF) 微型引线框(MLF) 是一种接近CSP的塑料封装封装,带有铜引线框基板。该封装使用封装底部的周边焊盘来提供与印刷电路板的电气接触。芯片连接焊盘暴露在封装表面的底部,以便在直接焊接到电路板时提供有效的热路径。这也可以通过使用向下键合或通过导电芯片连接材料进行电气连接来实现稳定的接地。 允许更高密度连接的最新设计变体是双排微型引线框架(DRMLF) 封装。这是一个 MLF 封装,带有两排连接盘,适用于需要多达 164 个 I/O 的设备。典型应用包括硬盘驱动器、USB 控制器和无线局域网。 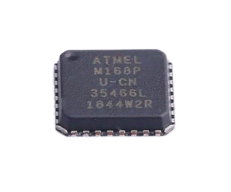 MLF封装QFP (quad flat package)四侧引脚扁平封装 MLF封装QFP (quad flat package)四侧引脚扁平封装四方扁平封装( QFP ) 是一种表面贴装 集成电路 封装,其“鸥翼”引线从四个侧面各延伸出。此类封装很少见,并且无法进行通孔安装。常见的版本有 32 到 304 个引脚,间距范围为 0.4 到 1.0 毫米。其他特殊变体包括薄型 QFP (LQFP) 和薄型 QFP (TQFP)。 QFP 组件封装类型在九十年代初期在欧洲和美国变得普遍,尽管它自七十年代以来一直用于日本 消费电子产品。在同一印刷电路板(PCB) 上,它通常与孔装(有时是插座)组件混合使用。 与 QFP 相关的封装是塑料引线芯片载体(PLCC),它与此类似但具有更大间距的引脚,1.27 毫米(或 1/20 英寸),在较厚的主体下方向上弯曲以简化插座(也可以进行焊接)。它通常用于NOR 闪存和其他可编程组件。  QFP封装 QFP封装薄四方扁平封装( TQFP ) 提供与公制 QFP 相同的优势,但更薄。常规 QFP 的厚度为 2.0 至 3.8 毫米,具体取决于尺寸。TQFP 封装范围从具有 0.8 毫米引线间距的 32 引脚(采用 5 毫米 x 5 毫米 x 1 毫米厚的封装)到 256 引脚、28 平方毫米、1.4 毫米厚和 0.4 毫米引线间距。 TQFP 有助于解决诸如增加电路板密度、芯片缩小程序、较薄的最终产品外形和便携性等问题。引线数范围从 32 到 176。主体尺寸范围从 5 mm x 5 mm 到 20 x 20 mm。TQFP 中使用铜引线框。TQFP 可用的引线间距为 0.4 mm、0.5 mm、0.65 mm、0.8 mm 和 1.0 mm。PQFP或塑料四方扁平封装是 QFP 的一种,更薄的 TQFP 封装也是如此。PQFP 封装的厚度从 2.0 毫米到 3.8 毫米不等。  TQFP 薄四方扁平封装 TQFP 薄四方扁平封装薄型四方扁平封装( LQFP ) 薄型四方扁平封装( LQFP ) 是一种表面贴装 集成电路组件引线从四个侧面延伸的封装格式。引脚从索引点逆时针编号。引脚之间的间距可以变化;常用间距为 0.4、0.5、0.65 和 0.80 毫米间隔。  LQFP薄型四方扁平封装 LQFP薄型四方扁平封装其他四方扁平封装类型  其他四方扁平封装类型 其他四方扁平封装类型一些 QFP 封装有一个裸露的焊盘。裸露焊盘是 QFP 下方或顶部的额外焊盘,可用作接地连接和/或封装的散热器。焊盘通常为 10 平方毫米或更大,并且焊盘向下焊接到地平面上,热量传递到 PCB 中。该裸露焊盘还提供牢固的接地连接。这些类型的 QFP 封装通常有一个-EP后缀(例如 LQFP-EP 64),或者它们有奇数个引线(例如 TQFP-101)。 陶瓷 QFP 封装: CERQUAD 和 CQFP: CERQUAD 包 因此,引线框连接在封装的两个陶瓷层之间。引线框使用玻璃连接。此软件包是 CERDIP 软件包的变体。CERQUAD 封装是 CQFP 封装的“低成本”替代品,主要用于地面应用。主要的陶瓷封装制造商是 Kyocera、NTK 等,并提供完整的引脚数范围 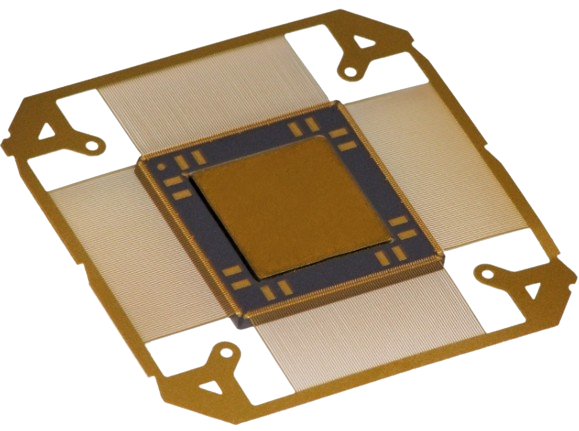 CERQUAD陶瓷 QFP封装 CERQUAD陶瓷 QFP封装CQFP 封装 因此,引线焊接在封装顶部。该封装为多层封装,以 HTCC(高温共烧陶瓷)形式提供。粘合甲板的数量可以是一个、两个或三个。封装采用镍加厚金层完成,除了焊接引线和焊接去耦电容器的地方外。这些封装是密封的。气密密封采用两种方法:共晶金锡合金(熔点 280 °C)或缝焊。缝焊显着降低了封装内部(例如芯片连接)的温升。这个包是用于 Space 项目的主要包。 由于 CQFP 封装体尺寸较大,因此寄生效应对该封装很重要。通过将去耦电容器安装在该封装的顶部来改善电源去耦。例如,TI 提供 256 引脚 CQFP 封装,其中可以将去耦电容器焊接在封装顶部例如,Test-expert 256 引脚 CQFP 封装,其中可以将去耦电容器焊接在封装顶部。 主要的陶瓷封装制造商有 Kyocera(日本)、NTK(日本)、Test-Expert(俄罗斯)等,并提供完整的引脚数范围。最大引脚数为 352 个引脚。  CQFP 封装BGA (ball grid array)球形触点陈列 CQFP 封装BGA (ball grid array)球形触点陈列球栅阵列( BGA ) 是一种用于集成电路的表面贴装封装(芯片载体) 。BGA 封装用于永久安装微处理器等设备。BGA 可以提供比双列直插或扁平封装更多的互连引脚。可以使用设备的整个底面,而不仅仅是周边。将封装的引线连接到将管芯连接到封装的导线或球的走线平均也比仅周边类型的走线更短,从而在高速下实现更好的性能。[需要引用] BGA 于 1990 年代推出,并于 2001 年开始流行。 BGA 器件的焊接需要精确控制,通常通过自动化过程完成,例如在计算机控制的自动回流焊炉中。  BGA (ball grid array)封装 BGA (ball grid array)封装BGA的不同规格 CABGA:芯片阵列球栅阵列 CBGA和PBGA表示阵列所附着的陶瓷或塑料基板材料。 CTBGA:薄芯片阵列球栅阵列 CVBGA:超薄芯片阵列球栅阵列 DSBGA:裸片尺寸球栅阵列 FBGA:基于球栅阵列技术的精细球栅阵列。它具有更薄的触点,主要用于片上系统设计;也称为细间距球栅阵列( JEDEC -Standard [10] ) 或Altera的细线 BGA。不要与强化 BGA 相混淆,FCmBGA:倒装芯片成型球栅阵列 LBGA : 薄型球栅阵列 LFBGA:薄型细间距球栅阵列 MBGA : 微型球栅阵列 MCM-PBGA : 多芯片模块塑料球栅阵列 nFBGA:新型精细球栅阵列 PBGA:塑料球栅阵列 SuperBGA(SBGA):超级球栅阵列 TABGA : 磁带阵列 BGA TBGA : 薄BGA TEPBGA:热增强塑料球栅阵列 TFBGA或薄而细的球栅阵列 UFBGA和UBGA以及基于pitch球栅阵列的超精细球栅阵列。 VFBGA:极细间距球栅阵列 WFBGA : 非常非常薄的细间距球栅阵列 实际上,将芯片管芯安装到载体上的倒装芯片方法也是一种 BGA 设计的衍生产品,其功能等效于球,称为凸块或微凸块。这是在已经微观的尺寸水平上实现的。为了更方便地使用球栅阵列器件,大多数 BGA 封装只在封装的外圈有球,而最里面的正方形是空的。 CSP (Chip Scale Package)芯片级封装芯片级封装或芯片级封装( CSP ) 是一种集成电路封装。 最初,CSP 是芯片尺寸封装的缩写。由于只有少数封装是芯片尺寸的,所以这个首字母缩写的意思被改编为芯片级封装。根据IPC的标准 J-STD-012,倒装芯片和芯片级技术的实现,为了符合芯片级,封装的面积必须不大于裸片的 1.2 倍,并且必须是单个-裸片,直接表面贴装封装。另一个常用于将这些封装作为 CSP 的标准是它们的球距不应超过 1 毫米。 管芯可以安装在其上形成焊盘或球的中介层上,如倒装芯片 球栅阵列(BGA) 封装,或者焊盘可以直接蚀刻或印刷到硅晶片上,从而使封装非常接近硅芯片的尺寸:这种封装称为晶圆级封装(WLP)或晶圆级芯片级封装(WL-CSP)。 芯片级封装可分为以下几类: 定制的基于引线框的 CSP (LFCSP) 基于柔性基板的 CSP 倒装芯片 CSP (FCCSP) 基于刚性基板的 CSP 晶圆级再分布 CSP (WL-CSP) Q:为什么会被称作CSP封装,它是芯片封装的天花板?我们又又怎么定义理解这个词在IC中的含义呢? A:从思维导图不难看出,封装形式自上而下封装形式和工艺逐步高级和复杂 决定封装形式的两个关键因素: 封装效率。芯片面积/封装面积,尽量接近1:1引脚数。引脚数越多,越高级,且工艺难度也响应增加。其中,CSP由于采用了FLIp Chip技术和螺片封装,达到了 芯片面积/封装面积=1:1,为目前最高级的技术。 |
【本文地址】
今日新闻 |
推荐新闻 |