用于处理硅晶圆的方法与流程 |
您所在的位置:网站首页 › FZ晶圆与CZ晶圆的区别 › 用于处理硅晶圆的方法与流程 |
用于处理硅晶圆的方法与流程
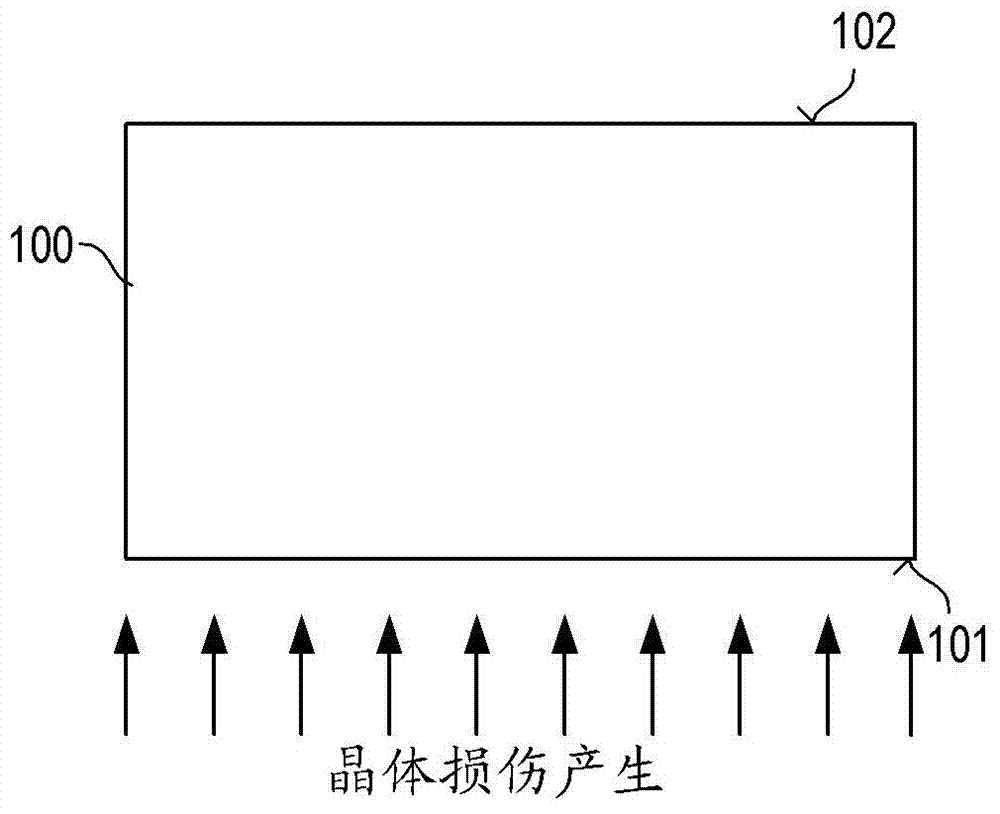 本公开大体涉及处理硅晶圆,特别是形成针对硅晶圆中的杂质的吸杂中心。 背景技术: 基于硅半导体晶圆生产半导体器件可包括多个过程序列,在该过程序列中例如掺杂区在晶圆中形成,以及金属化层在晶圆上形成。在这样的处理期间,不希望有的杂质(诸如金属原子)可能最终在晶圆中。因此,这些杂质可过度地影响成品的半导体器件的操作。例如,在功率半导体器件中,如果杂质最终在器件的下述区中则杂质可降低电压阻断能力:在该区中,高电场强度在器件的操作中可出现。 在晶圆的表面上形成的多晶硅层可以吸收那些杂质,并可在杂质引入处理之后被去除,以便去除杂质。然而,对于一些晶圆类型,用于在晶圆表面上形成多晶硅层的过程不是可用的。因此,存在对可替换的杂质吸杂的需要。 技术实现要素: 一个实施方式涉及一种方法。该方法包括:在半导体晶圆中形成含氧区;至少在含氧区中创建空位;以及在第一退火过程中使至少含氧区退火以便形成氧沉淀物。形成含氧区包括经由第一表面将氧引入到半导体晶圆中。 附图说明 下面参考附图解释示例。附图用于图示某些原理,使得只有对于理解这些原理所必要的方面被图示。附图并不按比例。在附图中,相同的参考符号表示相似的特征。 图1a-1e图示用于在半导体晶圆中形成吸杂中心的根据一个示例的方法; 图2图示在图1a-1e中示出的方法中的可选的另一过程步骤; 图3图示在通过两种不同的方法获得的半导体晶圆中的氧浓度; 图4图示在图1a-1e中示出的方法中的可选的另一过程步骤; 图5图示在图1a-1e中示出的方法中的可选的另一过程步骤; 图6示出在形成晶体管单元之后在图1e中示出的半导体晶圆; 图7示出在去除包含氧沉淀物的区之后在图6中示出的半导体晶圆; 图8示出在形成外延层和形成晶体管单元之后在图1e中示出的半导体晶圆;以及 图9示出在去除包含氧沉淀物的区之后在图8中示出的半导体晶圆。 具体实施方式 在下面的详细描述中,参考附图。附图形成描述的一部分并通过图示的方式示出其中本发明可被实践的特定实施例。应理解,本文中描述的各种实施例的特征可彼此组合,除非另外特别指明。 图1a-1e图示用于在半导体晶圆100中形成吸杂中心的根据一个示例的方法。图1a-1d示出在不同过程步骤期间的半导体晶圆100的区段的水平横截面视图,以及图1e示出在图1d中示出的晶圆100的一个区段的放大视图。晶圆100包括第一表面101和与第一表面相对的第二表面102。图1a-1d在垂直截面平面中示出晶圆100,该垂直截面平面是分别垂直于第一表面101和第二表面102的截面平面。 根据一个示例中,晶圆100是cz、mcz晶圆和fz晶圆之一。cz晶圆是从根据cz(直拉)方法生产的单晶(或晶锭)切割的晶圆。mcz晶圆是从根据mcz(磁性直拉)方法生产的单晶(或晶锭)切割的晶圆。fz晶圆是从根据fz(浮区)方法生产的单晶(或晶锭)切割的晶圆。那些类型的硅晶圆通常包括在mcz材料的情况下小于4e17cm-3的氧浓度或在fz材料的情况下小于1e16cm-3的氧浓度。根据一个示例,晶圆具有12英寸或更大的直径。“直径”是在横向平面中的晶圆的尺寸,该横向平面是平行于第一和第二表面101、102的平面。 用于形成吸杂中心的方法包括在半导体晶圆100中形成含氧区112。参考图1a和1b,这可包括经由第一表面101将氧引入到半导体晶圆100中,以及在第一退火过程中使至少区111退火,已经将氧引入到区111中。含氧区111的“宽度”d1是在半导体主体100的垂直方向上的含氧区111的尺寸,该方向是垂直于第一表面101的方向。在这个第一退火过程中,引入到半导体主体100中的氧扩散,以便形成含氧区112。根据一个示例,将含氧区112产生成具有在0.1微米(µm)和10微米之间、特别是在1微米和5微米之间的宽度d2。含氧区112的“宽度”d2是在半导体主体100的垂直方向上的含氧区112的尺寸,该方向是垂直于第一表面101的方向。含氧区112的宽度d2一般等于或大于含氧区111的宽度d1。根据一个示例,退火过程的温度高于1100°c、高于1200°c或高于1250°c。根据一个示例,退火过程的温度选自在1100°c和1400°c之间的范围。根据一个示例,退火过程中的温度高于1200°c,并且这个退火过程的持续时间在1小时和10小时之间。 根据一个示例,通过将氧离子注入到半导体主体100中来经由第一表面100引入氧。根据一个示例,可使用plad(等离子体掺杂)注入过程来执行这个注入。可根据要由注入过程获得的期望氧浓度和含氧区112的深度d2来选择注入剂量,要在该含氧区112中获得这个氧浓度。根据一个示例,含氧区112被产生,使得在这个含氧区112中的氧浓度是至少5e17cm-3,且含氧区的深度d2在5微米和20微米之间。在这种情况下,根据深度d2,从在至少2.5e14cm-2(=5e17cm-3×5e-4cm)和至少1e15cm-2(=5e17cm-3×20e-4cm)之间选择注入剂量。也就是说,在退火过程之后,含氧区112中的最低氧浓度是至少5e17cm-3,该含氧区112在第一表面101处开始并具有宽度d2。应注意,在如上面定义的含氧区112外部的氧浓度不一定是零,但低于上面提到的最低氧浓度,诸如5e17cm-3。例如,在含氧区112外部,氧浓度可从最低水平(在含氧区112的边界处)减小到低于最低水平的水平。低于最低水平的这个水平可对应于半导体主体100在氧被引入之前具有的氧水平。在含氧区112中的氧大部分是以间隙氧的形式的。小于20%的氧是以非间隙形式的。通常,从在1e14cm-2和1e18cm-2之间选择由深度d2和期望氧浓度的乘积给出的注入剂量。参考图1c,该方法还包括至少在含氧区112中创建空位。在图1c中,参考符号113表示下述区:该区通过额外创建空位而产生于含氧区112,并因此包括氧和空位。在下文中,这个区被称为含氧和空位区113。“空位”是在半导体晶圆100的晶格中的空位。根据一个示例,创建空位包括在含氧和空位区113中创建在1e17cm-3和1e19cm-3之间的空位浓度。创建空位可包括经由第一表面101和第二表面102之一将微粒注入到含氧区112中。例如,微粒是质子(氢离子)或氦(he)离子。根据一个示例,经由第一表面101注入微粒,且注入剂量选自在5e13cm-2和1e15cm-2之间的范围。例如,如果所注入的微粒是质子,则注入能量选自在1mev和5mev之间的范围,以及如果所注入的微粒是氦离子,则注入能量选自在3mev和10mev之间的范围。 该方法还包括在含氧和空位区113中形成氧沉淀物。形成这些氧沉淀物包括另一退火过程。在这个另一退火过程中,至少含氧和空位区113被退火。在另一退火过程中的温度例如选自在600°c和1050°c之间的范围。另一退火过程的持续时间可选自在1小时和30小时之间的范围。根据一个示例,另一退火过程包括至少将含氧和空位区113首先加热到在750°c和850°c之间的温度达1小时和5小时之间,并然后加热到在950°c和1100°c之间的温度达1小时和10小时之间。 图1d示出在形成氧沉淀物之后的晶圆,其中参考符号114表示含沉淀物区,即包含氧沉淀物的区。在图1e中示意性图示那些氧沉淀物op,图1e示出含沉淀物区114的放大细节。氧沉淀物op充当用于吸收杂质的吸杂中心,杂质可在形成晶圆100中的一个或多个半导体器件的过程步骤期间被引入到半导体晶圆100中。根据一个示例,另一退火过程是产生(一个或多个)半导体器件的部分。也就是说,在通过注入微粒创建空位之后,存在过程步骤,该过程步骤是在执行另一退火过程之前形成(一个或多个)半导体器件的部分。那些过程步骤可包括注入掺杂剂原子。在这种情况下,另一退火过程既用于产生氧沉淀物又用于激活所注入的掺杂剂原子。 实验已经证明,参考图1c解释的由微粒辐照诱发的空位能够实现大的氧沉淀物。这是因为空位能够实现氧沉淀物的快速生长。也就是说,在具有高空位浓度的区(诸如含氧和空位区113)中产生的那些氧沉淀物op大于在没有空位(或有较低浓度的空位)的区中产生的氧沉淀物。那些较大的氧沉淀物op比没有“空位支持”的情况下通过微粒辐照产生的较小氧沉淀物具有更高的温度稳定性。 如果质子用作用于创建空位的微粒,则这些质子中的大部分在另一退火过程中从半导体晶圆100扩散出。此外,另一退火过程使在含氧和空位区113中产生的大部分空位从半导体晶圆100扩散出或与硅间隙原子(interstitial)复合,使得由在第一区110中的微粒注入引起的损伤被“修复”。 参考图2,该方法可选地包括在引入参考图1a解释的氧之后和在参考图1b解释的退火过程之前在第一表面101上形成涂层200。这个覆盖层200在退火过程期间在适当的地方。覆盖层用于在退火过程期间经由第一表面101减小来自半导体晶圆100的氧的向外扩散。根据一个示例,涂层200是下述层之一:非晶硅层、单晶硅层、含氧层诸如通过化学气相沉积(cvd)沉积的氧化硅层、含氮层诸如通过cvd沉积的氮化硅和包含氧化硅和氮的层。实验已经证明,抵抗氧原子的向外扩散的这个阻挡层关于获得高密度的氧沉淀物是非常有益的。可使用注入过程经由第一表面101引入氧。根据一个示例,注入过程是束线注入过程。根据另一示例,注入过程是等离子体掺杂(plad)过程。这样的注入过程是通常已知的。例如,在下述文献中描述了这样的注入过程:a.renau,j.t.scheuer:"comparisonofplasmadopingandbeamlinetechnologiesforlowenergyionimplantation",proceedingsofthe14thinternationalconferenceonionimplantationtechnology.2002.isbn0-7803-7155-0。 在图3中,曲线301示意性图示可通过束线注入过程获得的氧浓度,以及曲线302示出可通过plad过程获得的氧浓度。这些曲线中的每个图示在垂直方向x上并在第一表面101处开始的氧浓度,该垂直方向是垂直于第一表面101的方向。曲线301和302示出在引入氧之后和在退火过程之前的氧浓度。在退火过程中,氧更深地扩散到半导体主体中,从而导致在图1b中示出的含氧区113中的更均匀的氧分布。与一般束线注入过程比较,通过使用用于注入氧的plad注入过程,可达到在较低成本下的高得多的注入剂量。 该方法还可包括此外或可替换地产生在相邻于第一表面101的区中的晶体损伤。产生那些晶体损伤可包括经由第一表面101注入微粒,其中这些微粒被选择,使得它们能够产生半导体晶圆100中的晶体损伤。参考图4,可在引入氧之前产生那些晶体损伤。可替换地,参考图5,在引入氧之后产生晶体损伤。 根据一个示例,注入半导体晶圆100中以便产生晶体损伤的微粒是硅原子(硅离子)。根据另一示例,微粒是氧原子(氧离子)。用对微粒足够高以产生晶体损伤的注入能量注入这些微粒。根据一个示例,注入能量选自在1mev和5mev之间的范围。在这个过程中,注入剂量一般比在参考图1a描述的注入过程中的更低,且注入能量一般更高。根据一个示例,注入能量选自在0.5mev和4mev之间的范围。为了获得在低注入能量下在半导体主体100中深的损伤,可使用沟道效应。也就是说,可在相对于第一表面101的某个角度下注入微粒,使得微粒可沿着半导体主体的晶格的晶体平面移动。 图6示出在另一处理之后的半导体晶圆100的垂直横截面视图,在该处理中晶体管器件的晶体管单元10分别被实现在半导体晶圆100中邻接第二表面102的区中和在第二表面102上。在这个处理期间,杂质诸如例如金属原子可被引入到半导体晶圆100中。在含氧沉淀物区114中的氧沉淀物充当针对那些杂质的吸杂中心。也就是说,那些杂质由杂质中心“捕获”,以便防止那些杂质不利地影响成品的半导体器件的操作。 参考图6,每个晶体管单元10包括源极区11、主体区12和漂移区13,其中漂移区13由单独的晶体管单元共享。此外,每个晶体管单元包括相邻于主体区12并通过栅极介质22与主体区12介质绝缘的栅极电极21。源极电极31电连接到单独晶体管单元10的主体区12和源极区11,并通过绝缘层32与栅极电极21介质绝缘。仅仅为了说明的目的,在图6中示出的示例中,晶体管单元10被绘制为沟槽晶体管单元。也就是说,这些晶体管单元的栅极电极21布置在从表面102延伸到半导体主体100中的沟槽中。在成品的晶体管器件中,通过经由源极电极31使源极区11和主体区12连接到源极节点并通过使栅极电极21连接到公共栅极节点g来并联连接单独晶体管单元10。晶体管器件可被实现为n型或p型晶体管器件。在n型晶体管器件中,源极区11和漂移区13是n掺杂的,而主体区12是p掺杂的。在p型晶体管器件中,源极区11和漂移区13是p掺杂的,并且主体区12是n掺杂的。 在图6中示出的示例中,漂移区13具有对应于半导体晶圆100的基本掺杂的掺杂。半导体晶圆100的“基本掺杂”是下述掺杂:半导体晶圆100在它从晶锭被切割之后和在本文所解释的处理发生之前所具有的掺杂。 图7示出另外的过程步骤之后在图6中示出的半导体晶圆100,在该过程步骤中含沉淀物区114被去除且漏极区14被形成。去除含沉淀物区114可包括下述过程中的至少一个:机械研磨过程、蚀刻过程、机械抛光过程、化学抛光过程或化学机械抛光(cmp)过程。这些过程中的每个减小半导体晶圆100的厚度,以便去除含沉淀物区114。通过此,由在含沉淀物区114中的氧沉淀物吸收的杂质被去除。在包含氧沉淀物的区中的蚀刻速率比不包含氧沉淀物的区中的高得多。因此,蚀刻过程可在靠近包含氧沉淀物的区的端部处停止自调节,使得可获得半导体主体100的自调节减薄。形成漏极区14可包括注入和/或扩散过程,在该过程中掺杂剂原子经由表面101’被引入到半导体晶圆100中。表面101’与第二表面102相对,并且是通过去除含氧沉淀物的区114而形成的表面。漏极区14可具有与漂移区13相同的掺杂类型,以便形成mosfet(金属氧化物半导体场效应晶体管)或可具有与漂移区13的掺杂类型互补的掺杂,以便形成igbt(绝缘栅双极晶体管)。 图8示出根据另一示例的半导体晶圆的垂直横截面视图。图8中示出的晶圆包括前面在本文中解释的晶圆100和在晶圆100上形成的外延层300。在这个示例中,半导体器件的有源器件结构集成在外延层300中。仅仅为了说明的目的,半导体器件再次是具有多个晶体管单元10的晶体管器件。在这个示例中,由单独晶体管单元10共享的漂移区13由外延层300形成。 图9示出在进一步处理之后在图8中示出的晶圆。这个进一步处理包括使晶圆100减薄,以便至少去除含沉淀物区114。晶圆100的剩余区段形成晶体管器件的漏极区。在这种情况下,晶圆100具有对应于漏极区14的掺杂的基本掺杂。 根据一个示例,半导体晶圆100包括仅一个半导体器件。根据另一示例,晶圆100包括多个不同的半导体器件。在这种情况下,在参考图6-9解释的处理之后,晶圆100可被细分成单独的半导体器件。 应注意,形成一个或多个晶体管器件(其中每个晶体管器件可包括多个晶体管单元)是半导体器件的多个不同示例中的仅一个,该半导体器件可集成在半导体晶圆100中。仅仅为了说明的目的,图6-9示出晶体管器件。 |
【本文地址】
今日新闻 |
推荐新闻 |